MCF51QE96CLH Freescale Semiconductor, MCF51QE96CLH Datasheet - Page 11
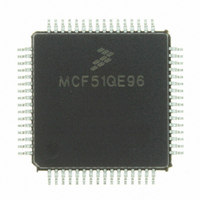
MCF51QE96CLH
Manufacturer Part Number
MCF51QE96CLH
Description
IC MCU 32BIT 96K FLASH 64-LQFP
Manufacturer
Freescale Semiconductor
Series
MCF51QEr
Datasheet
1.MCF51QE64CLH.pdf
(38 pages)
Specifications of MCF51QE96CLH
Core Processor
Coldfire V1
Core Size
32-Bit
Speed
50MHz
Connectivity
I²C, SCI, SPI
Peripherals
LVD, PWM, WDT
Number Of I /o
54
Program Memory Size
96KB (96K x 8)
Program Memory Type
FLASH
Ram Size
8K x 8
Voltage - Supply (vcc/vdd)
1.8 V ~ 3.6 V
Data Converters
A/D 20x12b
Oscillator Type
Internal
Operating Temperature
-40°C ~ 85°C
Package / Case
64-LQFP
Processor Series
MCF51QE
Core
ColdFire V1
Data Bus Width
32 bit
Data Ram Size
8 KB
Interface Type
SCI, SPI
Maximum Clock Frequency
50.33 MHz
Number Of Programmable I/os
54
Maximum Operating Temperature
+ 85 C
Mounting Style
SMD/SMT
3rd Party Development Tools
JLINK-CF-BDM26, EWCF
Development Tools By Supplier
EVBQE128, DEMOQE128
Minimum Operating Temperature
- 40 C
On-chip Adc
12 bit, 24 Channel
Lead Free Status / RoHS Status
Lead free / RoHS Compliant
Eeprom Size
-
Lead Free Status / Rohs Status
Lead free / RoHS Compliant
Available stocks
Company
Part Number
Manufacturer
Quantity
Price
Company:
Part Number:
MCF51QE96CLH
Manufacturer:
Freescale Semiconductor
Quantity:
10 000
The average chip-junction temperature (T
where:
For most applications, P
is:
Solving
where K is a constant pertaining to the particular part. K can be determined from equation 3 by measuring P
for a known T
for any value of T
3.5
Although damage from electrostatic discharge (ESD) is much less common on these devices than on early CMOS circuits,
normal handling precautions should be used to avoid exposure to static discharge. Qualification tests are performed to ensure
that these devices can withstand exposure to reasonable levels of static without suffering any permanent damage.
All ESD testing is in conformity with AEC-Q100 Stress Test Qualification for Automotive Grade Integrated Circuits. During
the device qualification ESD stresses were performed for the human body model (HBM), the machine model (MM) and the
charge device model (CDM).
A device is defined as a failure if after exposure to ESD pulses the device no longer meets the device specification. Complete
DC parametric and functional testing is performed per the applicable device specification at room temperature followed by hot
temperature, unless specified otherwise in the device specification.
Freescale Semiconductor
Equation 1
T
θ
P
P
P
JA
A
D
int
I/O
ESD Protection and Latch-Up Immunity
= Ambient temperature, °C
= P
= Package thermal resistance, junction-to-ambient, °C/W
= I
= Power dissipation on input and output pins — user determined
A
. Using this value of K, the values of P
int
DD
A
+ P
Latch-up
.
Machine
× V
and
Human
Model
Body
I/O
DD
I/O
Equation 2
, Watts — chip internal power
<< P
Series resistance
Storage capacitance
Number of pulses per pin
Series resistance
Storage capacitance
Number of pulses per pin
Minimum input voltage limit
Maximum input voltage limit
int
and can be neglected. An approximate relationship between P
for K gives:
Table 6. ESD and Latch-up Test Conditions
K = P
J
Description
MCF51QE128 Series Data Sheet, Rev. 7
) in °C can be obtained from:
D
P
T
× (T
D
J
= K ÷ (T
= T
A
D
+ 273°C) + θ
and T
A
+ (P
J
J
+ 273°C)
can be obtained by solving
D
× θ
JA
JA
Symbol
)
R1
R1
× (P
—
—
C
C
D
)
2
Value
1500
– 2.5
100
200
Equation 1
7.5
3
0
3
D
and T
Electrical Characteristics
and
Unit
pF
pF
J
Ω
Ω
Equation 2
V
V
(if P
D
I/O
(at equilibrium)
is neglected)
iteratively
Eqn. 1
Eqn. 2
Eqn. 3
11

















